人工智能等先进技术应用需要处理、存储、访问和重写数据,而HBM可以处理单元和内存之间的耦合,以实现访问和存储,减少延迟从而提高整个设备系统的速度,并减少功耗和热量等。所以HBM是推动AI技术发展的关键。
随着对更快数据访问的需求不断增长,HBM堆栈持续受到关注,这也给TSV(硅通孔)带来了更大的需求。
TSV技术是一种先进的封装和互连技术,通过在硅片上制作垂直贯通的微小通孔,并在通孔中填充导电材料,实现芯片内部不同层面之间的电气连接。这种技术打破了传统二维集成电路的局限,使得芯片在垂直方向上也能进行高密度集成,从而大大提高了芯片的性能和集成度。
TSV技术通过在硅片上垂直打孔,实现了不同硅片之间的电气连接,极大地提高了芯片的集成度和性能。这种技术的应用,使得内存解决方案能够满足AI时代对高带宽、大容量和低延迟的严苛要求。在AI应用中,对计算性能的要求极高。TSV技术通过提高芯片内部的互连密度,能够降低信号传输延迟,从而提升芯片的计算性能,满足AI应用对高性能计算的需求。
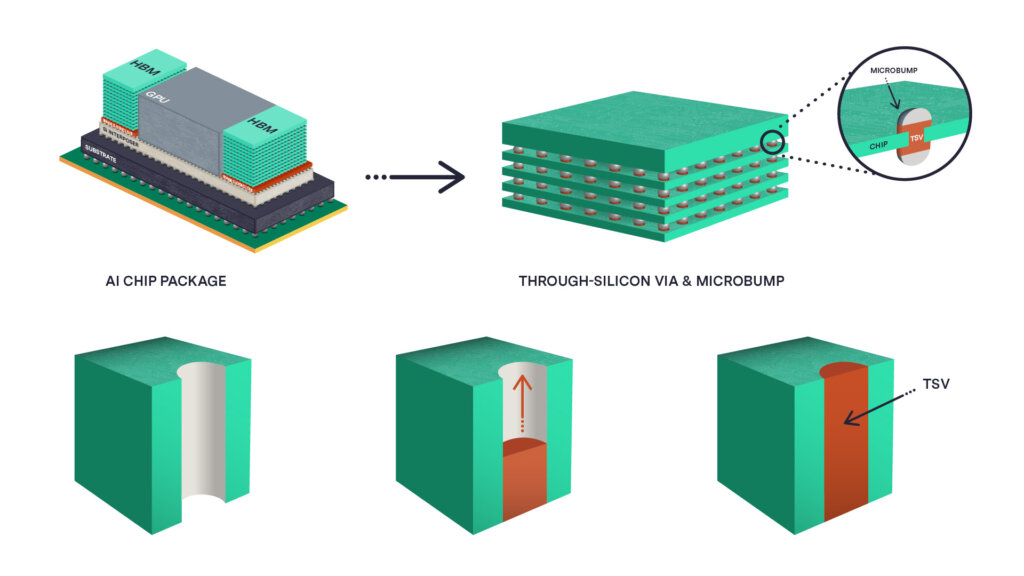
图:TSV技术:AI时代的基石(图源:半导体工程)
TSV技术被广泛应用于各种领域,如微处理器、存储器、传感器等,是推动集成电路制造技术向三维方向发展的重要技术之一。随着技术的不断发展,TSV技术将在逻辑芯片、存储器芯片、CPU以及异质集成等领域得到进一步应用。
TSV技术的实现设计一系列复杂的工艺步骤,包括硅片准备、深硅刻蚀、孔动隔离、种子层沉积、电镀填平、平面化和测试与封装等。其中,深硅蚀刻是TSV技术中最关键的步骤之一,它使用干法或湿法蚀刻技术在硅片上蚀刻出垂直的空洞,这些孔洞的直径和深度根据设计需求而定,但通常孔径较小,深度则可能达到数百微米。
随着智能手机、平板电脑、笔记本电脑等电子产品的普及,以及人工智能、物联网等领域的快速发展,对芯片集成度和性能的要求越来越高。TSV技术作为实现三维集成电路的关键技术之一,其应用前景非常广阔。在智能手机领域,TSV技术可以实现更高效的处理器和更强大的图形处理能力,提升用户体验。在物联网领域,TSV技术可以实现更高密度的传感器集成和更低功耗的数据传输,推动物联网应用的普及。在人工智能领域,TSV技术可以提供更强大的计算能力和更高的存储密度,支持更复杂的算法和更大的数据集处理。
随着技术的不断进步和市场的不断扩大,TSV技术有望在电子制造领域发挥更加重要的作用。通过降低制造成本、提高热管理性能和增强可靠性等方面的努力,TSV技术将推动三维集成电路技术的进一步发展,为电子产业的创新和发展提供有力支持。






