随着高性能计算和人工智能领域的快速发展,对高带宽内存(HBM)的需求日益增长。HBM以其高速度、高容量和低功耗特性成为高端计算设备的首选内存解决方案。然而,随着技术的进步和市场对更高内存密度的需求,HBM制造商面临着新的挑战。在这种情况下,液态模塑料下填料(Liquid Mold Underfill,简称LMUF)技术应运而生,成为HBM制造过程中的关键选择。以下是HBM制造商选择LMUF的几个主要原因。
提升热传导性能
HBM内存的堆叠技术要求在保持标准封装高度的同时,增加DRAM层的数量。这导致堆叠芯片的散热成为一个重大挑战。SK海力士等公司采用的液态环氧模塑料(Liquid EMC)作为下填料,相较于传统非导电膜(NCF),其热导率提高了一倍,有效提高了芯片的散热效率。
增加内存密度
液态模塑料下填料技术允许制造商在不牺牲性能或产量的前提下,制造更薄的DRAM层,并通过减少层间空间来增加DRAM层的数量。这不仅提高了内存模块的整体密度,而且有助于实现更高的内存容量。
简化组装过程
采用液态模塑料下填料的Mass Reflow Molded Underfill(MR-MUF)技术,可以在回流过程中一次性粘合多个DRAM芯片,同时填充芯片之间的间隙。这种技术简化了组装流程,提高了生产效率。
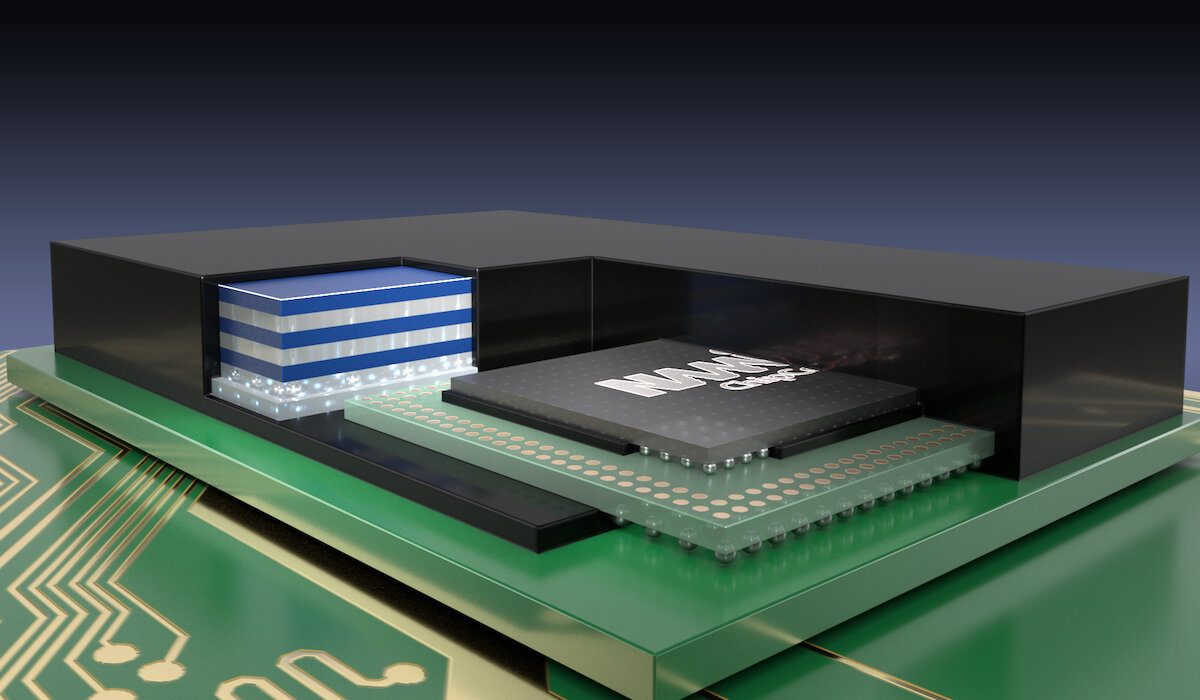
图:LMUF:HBM制造商的新选择
提高可靠性
液态模塑料下填料材料以其高可靠性而闻名,这对于确保HBM产品的长期稳定性和性能至关重要。
成本和吞吐量效率
液态模塑料下填料的使用有助于降低成本并提高生产吞吐量。它还支持更薄的封装设计,这对于电子设备的小型化至关重要。
适应狭窄间距
液态压缩模塑料下填料(LCMUF)能够流入狭窄的间距,这对于满足现代HBM堆叠的精细间距要求至关重要。
改善毛细下填料流动和生产效率
液态模塑料下填料特别适合于倒装芯片封装,因为它结合了下填料和上模塑料,改善了毛细下填料流动并提高了生产效率。
综上所述,液态模塑料下填料技术因其在热管理、内存密度、生产效率和可靠性方面的优势,已成为HBM制造商的首选。随着技术的不断进步,我们可以预见,液态模塑料下填料将在未来的高性能内存解决方案中发挥越来越重要的作用。






